
이번 글에서는 LPW에 대한 여러 기사들을 정리해 보도록 하겠습니다.
먼저, LPW는 LLW 또는 커스텀 메모리로 불립니다.
각각의 용어를 살펴보면
LPW: Low Power Wide I/O
LLW: Low Latency Wide I/O
명확하게 정해진 용어가 없었으나 요즘엔 LPW라는 표현을 쓰는 것 같습니다.
LPW DRAM, LPW NAND 등 다양한 방식이 있는데요, 일단 어떤 이름이든지 "Wide I/O"라는 표현이 사용됩니다.
이는 말그대로 I/O 수를 늘린 메모리라는 뜻입니다. 입출력 단자를 늘려 bandwidth를 개선하는 것입니다.
이러한 방식으로 사용되는 것 중 하나가 HBM입니다. DRAM 다이를 적층한 뒤 1024개의 I/O를 뚫어 (HBM4에서는 2048개) 대역폭을 확장 시킨 방식으로 고성능 컴퓨팅 기기 (HPC)에 사용되는 방식입니다.
하지만 현재 AI는 단순히 대량의 데이터를 학습하는 것에서 발전하여 휴대폰이나 노트북 등 엣지 디바이스나 AR, VR 등 실질적으로 사용자에게 서비스를 제공하는 방식으로 변화하고 있습니다.
보통 노트북이나 휴대폰에 탑재되는 LPDDR DRAM은 HBM처럼 대역폭이 크지 않아서 AI 연산 속도를 구현할 수 없다는 문제가 있습니다.
따라서 LPDDR의 I/O 단자를 늘려 대역폭을 늘린 LPW DRAM이 개발되고 있습니다.
LPW는 입출력 속도를 늘리는 대신 개별 통로의 속도는 낮춰 전력 소모량을 줄이면서 성능을 높이는 목적을 갖습니다. 또한 연산을 담당하는 칩 바로 옆에 붙어 연산을 도와 지연성을 줄인다는 특징을 갖습니다.


이러한 LPW DRAM과 유사한 개념이 이미 상용화된 사례도 있습니다.
바로 SK하이닉스의 커스텀 DRAM입니다. 이 커스텀 DRAM은 애플의 AR 헤드셋 '비전 프로'에 탑재되었는데요.
이 커스텀 DRAM은 비전 프로 안에서 연산을 담당하는 R1칩 바로 옆에 탑재되어 있고, I/O 수가 기존 LPDDR DRAM보다 8배 많은 512개가 있습니다.
LPW와 LPDDR의 가장 큰 차이는 I/O 수도 있지만 커스텀 여부입니다. LPDDR은 범용 제품인 반면, LPW는 고객사의 요청에 따라 프로세서에 붙이기 위한 핀 위치 등을 반영하여 최적화된 설계가 필요합니다.
삼성전자는 3년 뒤 (2028년) 온디바이스 AI에 최적화된 LPW DRAM이 적용된 첫 모바일 제품이 출시될 것이라고 밝힌 바가 있습니다. 구체적으로 LPW, LLW DRAM 출시 시기를 공개한 것은 처음이라고 합니다.

LPW DRAM이 LPDDR5X 대비 입출력속도도 166% 개선되어 초당 200GB를 넘고 전력 소모도 54% 줄어 1.9 pJ/bit에 해당할 것으로 이야기 했습니다.
그림에서도 표현되어 있듯이, I/O 수를 늘리고, vertical wire bonding을 적용하여 공간 및 전력 효율을 높이겠다고 발표했습니다.

또한 어제 나온 기사 중에서 SK하이닉스가 LPW NAND 상표를 출원했다는 소식이 있었습니다.
https://www.sisajournal-e.com/news/articleView.html?idxno=410253
[단독] SK하이닉스, 차세대 저전력 낸드 개발 - 시사저널e
[시사저널e=고명훈 기자] SK하이닉스가 저전력·고대역폭을 구현하는 신규 메모리 반도체 LPW(Low Power Wide I/O) 낸드플래시 개발에 착수했다. 온
www.sisajournal-e.com
LPW DRAM과 마찬가지로 온디바이스 AI를 위해 기존 NAND flash 소자에서 I/O 수를 늘리는 방식으로 성능을 끌어올리는 소자로 추측됩니다.
이 기사에서 LPW NAND가 최근 샌디스크가 발표한 HBF (High Bandwidth Flash)와 유사한 구조로 추정된다고 하는데요.
그래서 HBF에 대한 기사도 간단히 정리해보겠습니다.
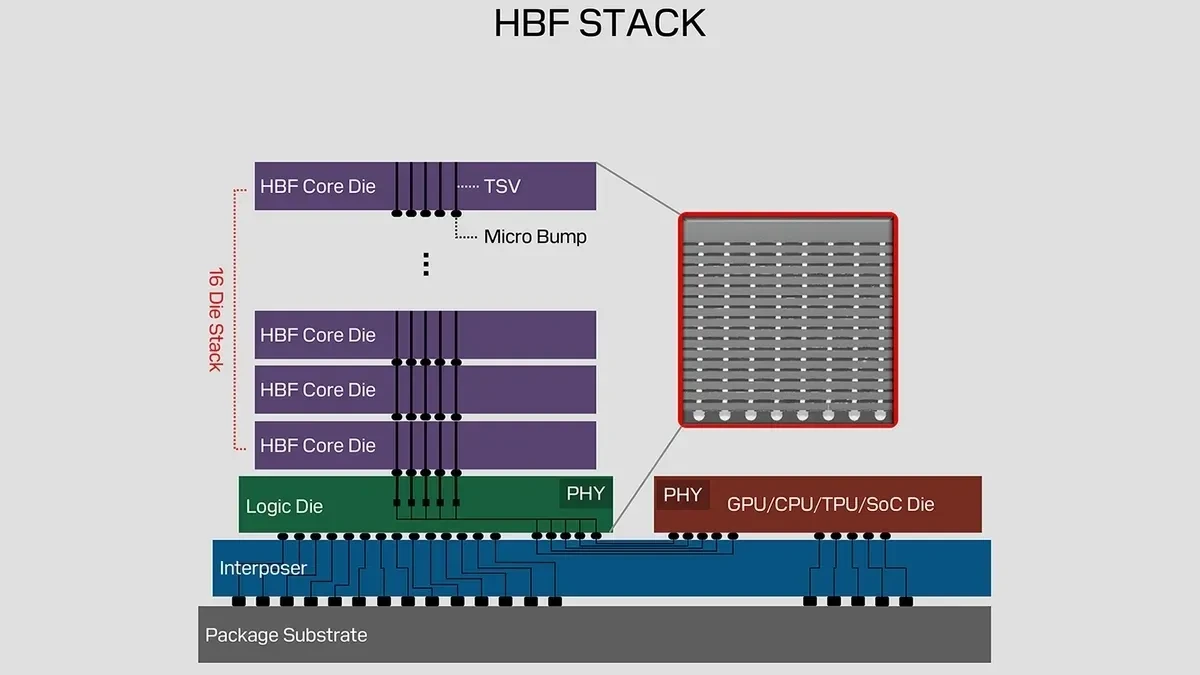
HBF는 DRAM 다이를 쌓은 후 TSV 통로를 연결해 고대역폭을 구현하는 HBM과 비슷한 방식이지만, DRAM 다이 대신 NAND flash 다이를 CBA 방식 (CMOS directly Bonded to Array)으로 쌓아올리는 방식입니다.
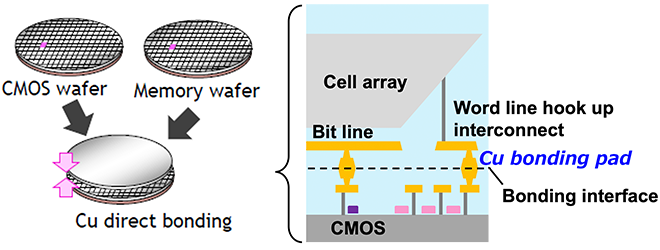
여기서 CBA는 하이브리드 본딩과 유사한 방식으로 CMOS peripheral circuit과 cell array를 서로 다른 웨이퍼에서 형성한 후 Cu 본딩을 하는 방식이라고 합니다.
샌디스크의 1세대 HBF는 16층의 NAND 플래시를 적층해 512 GB의 용량을 구현한다고 합니다. 이 HBF 8개를 GPU에 붙인다면 4TB라는 큰 용량을 구현할 수 있습니다. 하지만 HBM보다는 대역폭은 낮을 것으로 예상되고 있고, 그렇기 때문에 HBM과 혼용해서 사용하는 방식도 제안되고 있습니다.

SK하이닉스의 LPW NAND는 성능에 초점을 맞춘 소자인 만큼, TLC나 QLC보다는 SLC을 채택할 가능성이 높다고 합니다.
입출력 통로를 늘리고, 개별 통로 속도는 낮춰서 전력 소모를 줄이는 방식으로, 온디바이스 AI 향으로 개발을 시작했다고 설명했습니다.
기술적인 내용 이외도 중요한 점은 HBM4도 커스텀 로직 다이가 탑재되고, LPW DRAM 등 다양한 메모리 시장이 확대되면서, '고객 맞춤형 메모리' 시대가 열릴 것이라는 점입니다. 온디바이스 AI를 탑재하는 기기들은 휴대폰부터 노트북, AR/VR 기기 등 다양하고 또 원하는 기능도 다를 것이기 때문에 고객사에 맞춘 설계가 필요합니다. 따라서 수주 형태로 사업을 운영할 수 있어 메모리 제조사들은 가격 협상력을 유지하면서 실적을 확보할 수 있을 것으로 보입니다.
참고
https://www.sedaily.com/NewsView/2D6KI98LFN
삼성전자가 칼 갈고 준비한 메모리 新무기 3선 [강해령의 하이엔드 테크] <1편>
산업 > 기업 뉴스: 정보기술(IT) 시장에 관심 많으신 독자 여러분, 안녕하세요. 인공지능(AI) 시대가 열리면서 반도체의 모양·성능도 정말 ...
www.sedaily.com
https://www.sedaily.com/NewsView/2GP0NJ6DA1
[단독] 삼성, AI용 고성능 '모바일 HBM' LPW D램 3년 뒤 선보인다
산업 > IT 뉴스: 삼성전자(005930)가 차세대 모바일 메모리로 꼽히는 저전력광폭입출력(Low Power Wide I/O·LPW) D램을 3년 뒤 선보인다. ...
www.sedaily.com
https://www.edaily.co.kr/News/Read?newsId=04044246639117208&mediaCodeNo=257
메모리 新패러다임…'모바일계 HBM' LLW D램 뜬다
삼성전자(005930)가 D램 시장의 새로운 샛별로 불리는 ‘LLW(Low Latency Wide IO·저지연 와이드 I/O) D램’ 개발에 주력하며 차세대 반도체 시장에 역량을 쏟고 있다. LLW는 빠른 데이터 처리 속도는 물론
www.edaily.co.kr
https://nownews.seoul.co.kr/news/newsView.php?id=20250216601002
낸드 플래시 메모리를 HBM처럼? HBF 기술 공개한 샌디스크 [고든 정의 TECH+]
현재 생산되는 메모리 반도체는 D램 같은 휘발성 메모리와 낸드 플래시 메모리 같은 비휘발성 메모리로 나눠볼 수 있습니다. 전자는 전기 공급이 없으면 데이터가 사라지지만 대신 매우 빠르기
nownews.seoul.co.kr
https://www.kioxia.com/en-jp/rd/technology/topics/topics-64.html
Development of CMOS Directly Bonded to Array(CBA) Technology for 3D Flash Memory | KIOXIA - Japan (English)
CMOS directly bonded to array(CBA) technology with Cu direct bonding process has been developed and applied to BiCS FLASH™ generation 8 for performance improvement and cost reduction of 3D flash memory.
www.kioxia.com
https://www.sedaily.com/NewsView/29X8D49HRB
온디바이스 AI, 메모리 반도체 새 먹거리로…LLW D램 뜬다 [Biz-플러스]
챗GPT가 이끈 생성형 인공지능(AI)에 이어 이번에는 온디바이스(On-Device) AI 시장이 열리며 새로운 메모리 반도체가 주목받고 ...
www.sedaily.com
'반도체 산업 트렌드' 카테고리의 다른 글
| SOCAMM이란? (0) | 2025.03.24 |
|---|---|
| ASML의 "High-NA EUV" (0) | 2025.03.07 |
| 램리서치의 "극저온 식각" (0) | 2025.02.21 |


